-

打开频谱资源新大门的核心载体
核心技术优势太赫兹芯片工作在 0.3-3THz 的电磁波频段,这一被称为 "太赫兹空隙" 的频谱区域,兼具微波的穿透性与光波的成像分辨率,展现出独特的技术优势。在成像分辨率方面,太赫兹波的波长仅 0.1-1 毫米,较微波(厘米级)提升 100 倍以上,太赫兹成像芯片的…
2025-07-11 -

硅光子集成芯片
核心技术优势硅光子集成芯片通过在硅基平台上集成激光器、调制器、探测器等光学元件,实现了 “光信号传输 + 电信号处理” 的无缝融合,其带宽与功耗优势远超传统电互联。在数据传输速率方面,单通道硅光子芯片的速率已达 100Gbps,采用波分复用技术后,单根光纤可实现 8…
2025-07-11 -

突破平面集成极限的立体解决方案
核心技术优势三维集成电路(3D IC)通过硅通孔(TSV)将多层芯片垂直堆叠,实现了从 “平面扩展” 到 “立体集成” 的跨越,其空间利用率较传统 2D IC 提升 5-10 倍。在相同功能下,3D IC 的封装面积减少 40%-60%,某 12 层堆叠的存储芯片体积仅为平面方案的 1/8,特别适…
2025-07-11 -

Chiplet 封装技术
核心技术优势Chiplet 封装技术通过将多个异构芯粒(如计算芯粒、存储芯粒、IO 芯粒)集成在单一封装内,实现了 “模块化造芯” 的创新模式,其性能与成本平衡优势显著。与传统单芯片 SoC 相比,Chiplet 方案的设计周期缩短 50% 以上,7nm 工艺的 AI 芯片采用 Chiplet 后,…
2025-07-11 -

半导体封装基板
核心技术优势半导体封装基板作为芯片与 PCB 之间的关键连接载体,其布线密度和信号传输性能直接决定封装效率。与传统 PCB 相比,封装基板在线宽 / 线距(L/S)上有显著优势。高端封装基板的 L/S 可达到 2μm/2μm,是普通 PCB(50μm/50μm)的 25 倍以上,能实现更多 I/…
2025-07-11 -
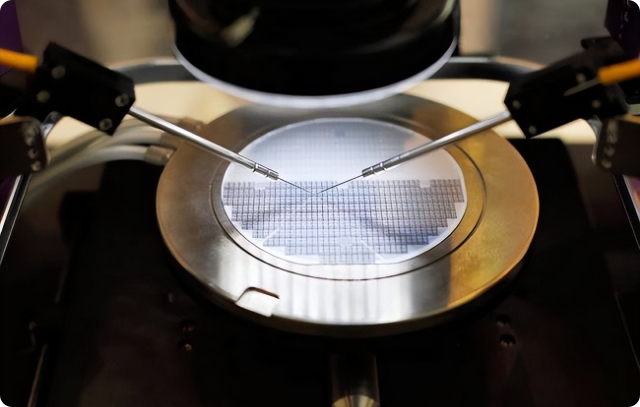
化学机械抛光浆料
核心技术优势化学机械抛光(CMP)浆料作为芯片制造中实现表面全局平坦化的核心材料,其化学与机械作用的平衡直接决定抛光效果。与传统研磨液相比,半导体级 CMP 浆料在材料去除速率和选择性上有严苛要求。例如,硅晶圆抛光用的二氧化硅浆料,材料去除速率需稳定在 1000-2…
2025-07-11
